近日,就碳化硅单晶制备和碳化硅切割技术方面,有新进展。
浙大联合实验室制备出厚度达100 mm碳化硅单晶
4月26日,浙大杭州科创中心官微发文称,浙江大学杭州国际科创中心(简称科创中心)先进半导体研究院-乾晶半导体联合实验室(简称联合实验室)首次生长出厚度达100 mm的超厚碳化硅单晶!

source:先进半导体研究院
文章指出,为提升碳化硅晶体厚度,联合实验室开展了提拉式物理气相传输(Pulling Physical Vapor Transport, PPVT)法生长超厚碳化硅单晶的研究(图1a)。
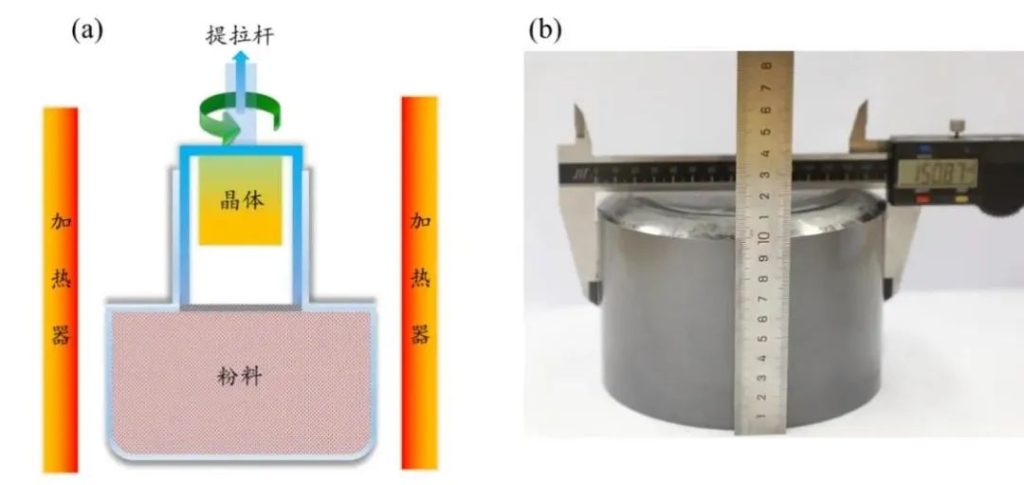
source:先进半导体研究院
采用提拉式物理气相传输法,联合实验室成功生长出直径为6英寸(即150mm)的碳化硅单晶,其厚度突破了100mm。测试加工而得的衬底片的结果显示,该超厚碳化硅单晶具有单一的4H晶型(图2a)、结晶质量良好(图2b),电阻率平均值不超过~ 30 mΩ·cm。
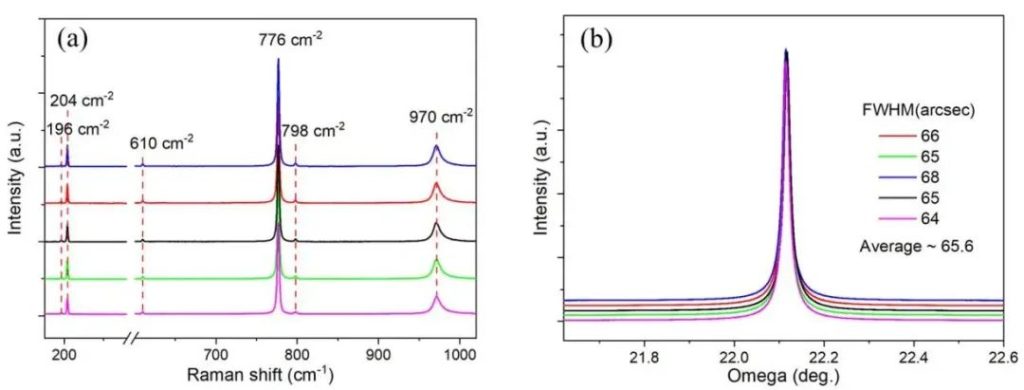
source:先进半导体研究院
南京大学推出碳化硅激光切片技术
近日,南京大学成功研发出大尺寸碳化硅激光切片设备与技术,标志着我国在第三代半导体材料加工设备领域取得重要进展。该技术不仅解决了传统切割技术中的高材料损耗问题,还大幅提高了生产效率,对推动碳化硅器件制造技术的发展具有重大意义。
碳化硅(SiC)作为一种关键的战略材料,对安全、全球汽车产业和能源产业都至关重要。南京大学研发的这项新技术,针对碳化硅单晶加工过程中的切片性能进行了重要改进,能够有效控制晶片表层裂纹损伤,从而提高后续薄化、抛光的加工水平。

source:南京大学
“传统的多线切割技术在加工碳化硅时存在材料损耗率高和加工周期长的问题,这不仅增加
了生产成本,也限制了产能。”项目负责人介绍,传统方法在切割环节的材料利用率仅为50%,而经过抛光研磨后的材料损耗高达75%。
为了克服这些挑战,南京大学的技术团队采用激光切片设备,显著降低了材料损耗,并提升了生产效率。以一个20毫米的SiC晶锭为例,传统线锯技术能生产30片350微米的晶圆,而激光切片技术能生产50多片,甚至在优化晶圆几何特性后,可以将单片晶圆厚度减少到200微米,从而使单个晶锭生产的晶圆数量超过80片。
此外,南京大学研发的激光切片设备在切割时间上也具有显著优势。6英寸半绝缘/导电型碳化硅晶锭的单片切割时间不超过15分钟,单台设备的年产量可达30000片以上,且单片损耗得到有效控制,半绝缘碳化硅晶锭单片损耗控制在30微米以内,导电型则在60微米以内,产片率提升超过50%。
在市场应用前景方面,大尺寸碳化硅激光切片设备将成为未来8英寸碳化硅晶锭切片的核心设备。目前,此类设备仅有日本能够提供,价格昂贵且对中国实行禁运。国内需求超过1000台,而南京大学研发的设备不仅可用于碳化硅晶锭切割和晶片减薄,还适用于氮化镓、氧化镓、金刚石等材料的激光加工,具有广阔的市场应用前景。
来源:先进半导体研究院、中国光学期刊网、集邦化合物半导体整理
更多SiC和GaN的市场资讯,请关注微信公众账号:集邦化合物半导体。
