碳化硅(SiC)具有宽带隙、高击穿场强、高饱和电子漂移速率和高热导率等优异性能,在新能源汽车、光伏和5G通讯等领域具有重要的应用。与目前应用广泛的4H-SiC相比,立方SiC(3C-SiC)具有更高的载流子迁移率(2-4倍)、低的界面缺陷态密度(低1个数量级)和高的电子亲和势(3.7 eV)。
利用3C-SiC制备场效应晶体管,可解决栅氧界面缺陷多导致的器件可靠性差等问题。但3C-SiC基晶体管进展缓慢,主要是缺乏单晶衬底。前期大量研究表明,3C-SiC在生长过程中很容易发生相变,已有的生长方法不能获得单一晶型的晶体。
根据经典晶体生长理论,对于光滑界面晶体,同质二维形核需要克服临界势垒,存在临界Gibbs自由能或过饱和度,而生长则可以在任意小的过饱和度下进行。对于异质形核,由于引入了新的固-固界面能,二维形核需克服更高的临界势垒。因此在相同过饱和度下,同质形核和生长在能量上明显优于异质形核和生长,使得后者很难发生。
近期,中国科学院物理研究所/北京凝聚态物理国家研究中心的陈小龙团队提出了调控固-液界面能,在异质籽晶上较同质籽晶优先形核和生长的学术思想。
主要包括:1)3C(111)面和4H(0001)面的晶格失配度小,固-固界面能很低;2)4H和3C体相Gibbs自由能的差别较小;3)如果通过调控熔体成份,使得3C(111)-熔体的界面能较4H(0001)-熔体的界面能足够低,二维形核以及后续生长的Gibbs自由能则对于3C相更有利。该团队自主设计、搭建了超高温熔体表面张力和固-液接触角测试设备,在高温下测量了不同成份熔体的表面张力,熔体与4H-SiC、3C-SiC的接触角,获得了4H-SiC、3C-SiC与高温熔体的固-液界面能的变化规律,验证了界面能调控的可行性。该团队利用高温液相法,实现了相同过饱和度条件下3C-SiC的Gibbs自由能更低的要求,抑制了生长过程中的相变,在国际上首次生长出了直径2-4英寸、厚度4-10mm、单一晶型的3C-SiC单晶,如图1和图2所示。
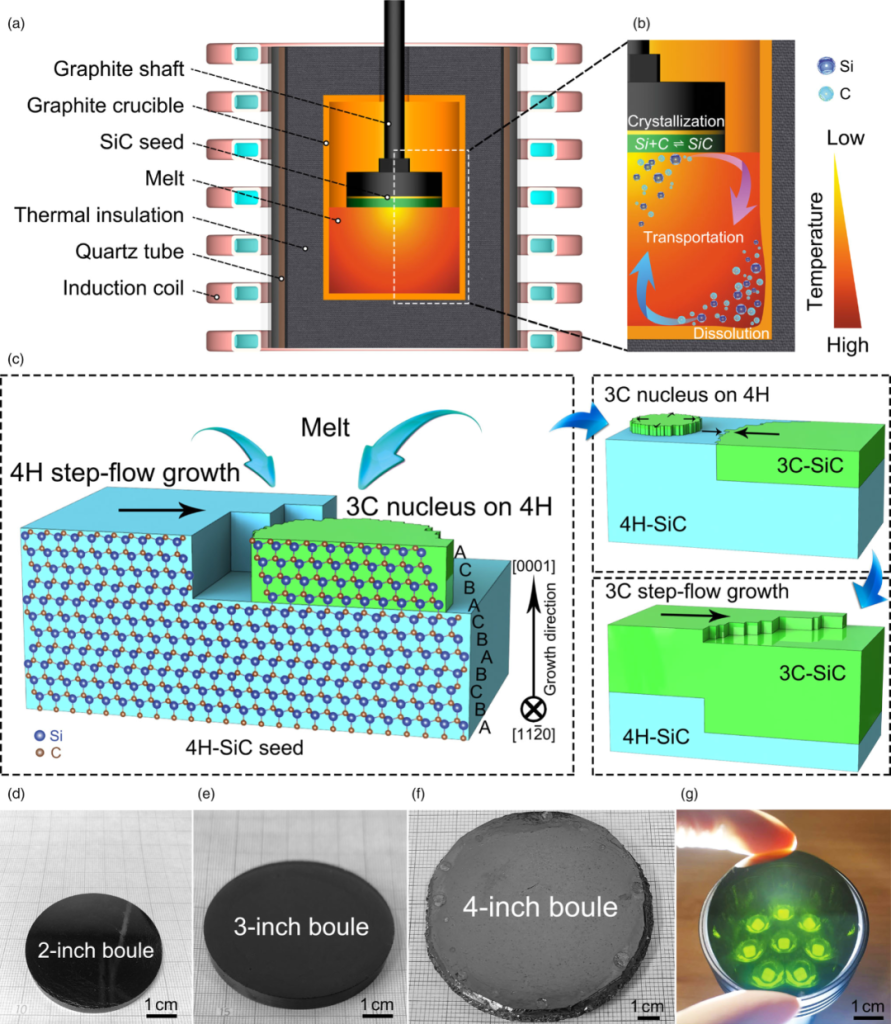
图1. 采用高温液相法,在六方碳化硅(4H-SiC)籽晶上实现了2-4英寸、厚度4-10 mm、立方碳化硅(3C-SiC)的异质形核和晶体稳定生长
沿晶体厚度方向的Raman散射光谱测量结果表明,生长一开始,3C-SiC即在4H-SiC籽晶上形核、生长,两者共存区小于20 μm,见图2(a-b),进一步证实了上述理论。(111)生长面的X射线摇摆曲线半高宽的平均值为30 arcsec,表明生长的3C-SiC具有高的结晶质量。3C-SiC单晶的室温电阻率只有0.58 mΩ·cm,为商业化4H-SiC晶片电阻率(15-28 mΩ·cm)的~1/40,有望降低器件的能量损耗。

图2. 3C-SiC晶型的确定。a) 在(111)生长面上随机选取20个点的Raman散射光谱图,插图为测试点在晶体上的位置分布图。b) 沿晶体厚度方向的Raman散射光谱图。c) 300 K测量的光致发光(PL)图谱。d) 高角环形暗场扫描透射电镜(HAADF-STEM)图。插图为沿[110]晶带轴的选区电子衍射(SAED)图晶圆级3C-SiC单晶的生长填补了国内外空白,使3C-SiC晶体的量产成为可能,也为开发性能优异的电力电子器件提供了新的契机。同时,异质籽晶上较同质籽晶优先形核和生长的机制拓展了传统的晶体生长理论。
来源:中国工陶
更多SiC和GaN的市场资讯,请关注微信公众账号:集邦化合物半导体。
