近日,合肥钧联汽车电子有限公司(简称:钧联电子)宣布完成近亿元A+轮融资。本轮融资由中信建投资本领投,海螺资本、芜湖科创集团共同跟投。
钧联电子成立于2020年,是专注于第三代半导体SiC(碳化硅)功率模块及电驱动系统研发、制造与销售的国家高新技术企业。公司深耕800V高压电控、... [详内文]
SiC企业完成近亿元A+轮融资 |
| 作者 KikiWang|发布日期 2026 年 06 月 01 日 13:38 | 分类 企业 |



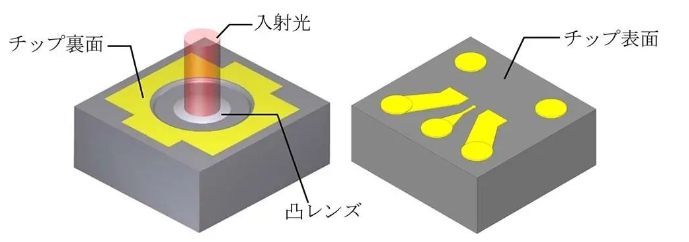

-300x300.png)



-298x300.png)
-298x300.png)


-297x300.png)

