近日,麻省理工学院(MIT)的研究团队取得了一项重大技术突破,开发出一种创新的制造工艺,能够将高性能氮化镓(GaN)晶体管与标准硅芯片进行三维集成。这一成果有望显著提升高频应用(如视频通话和实时深度学习)的性能表现,为半导体技术的发展开辟新的道路。
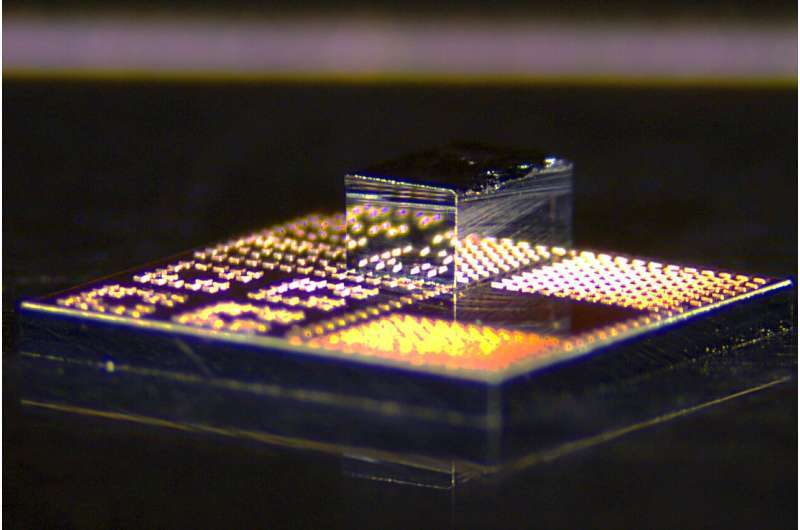
图片来源:麻省理工学院新闻
鉴于氮化镓高昂的成本以及与硅基芯片的兼容性问题,MIT团队提出了新制造方案,在氮化镓晶圆表面密集制造微型晶体管,切割成仅240×410微米的独立单元(称“dielet”),再通过铜柱低温键合技术,精准嵌入硅互补金属氧化物半导体(CMOS)芯片。
这一新技术的关键在于“分而治之”的策略。研究团队开发了专用工具,利用真空吸附和纳米级定位技术,将dielet与硅基板的铜柱接口精确对齐,并在400摄氏度以下完成低温键合。与传统的金焊工艺相比,铜柱结合不仅成本更低,而且导电性更优,同时完全兼容现有的半导体生产线。
在实验中,团队制作的功率放大器芯片(面积不足0.5平方毫米)在无线信号强度和能效方面均超越了传统的硅基器件。这种混合芯片能够显著提升智能手机的通话质量、带宽和续航能力,同时降低系统的发热。这种将硅基数字芯片与氮化镓优势相结合的混合芯片,有望在通信、数据中心及量子计算等领域引发一场技术革命。
IBM的科学家Atom Watanabe对这一成果给予了高度评价,认为它“重新定义了异质集成的边界,为下一代系统的微型化和能效优化树立了新的标杆”。这一突破不仅展示了氮化镓在高频应用中的巨大潜力,也为未来半导体技术的发展提供了新的方向和思路。
(集邦化合物半导体整理)
更多SiC和GaN的市场资讯,请关注微信公众账号:集邦化合物半导体。
