“广东致能半导体有限公司”官微消息,近期,广东致能创始人黎子兰博士参加在瑞典举办的第十五届国际氮化物半导体会议(ICNS-15)并作邀请报告(Invited Talk)。报告分享了团队在硅基垂直氮化镓功率器件(GaN HEMT)技术上的原创性突破及应用前景。
广东致能团队全球首创在硅衬底上实现垂直GaN/AlGaN异质结构及垂直二维电子气沟道(2DEG)的直接外延生长,通过精准工艺调控,制备出低位错密度的氮化镓鳍状结构,该方法具备极高的外延结构设计自由度。
基于这一创新平台,团队成功研制出全球首个具有垂直2DEG沟道的常开型器件(D-mode VHEMT)及阈值电压可调的常关型器件(E-mode VHEMT)。在工艺集成方面,通过源/栅电极选择性刻蚀及硅衬底完全去除工艺,实现了全垂直电极结构布局,可显著提升器件散热效率。该创新技术在先进工艺平台加持下具备极高的量产可行性,同时还为器件微缩和大电流性能迭代(功率密度)提供了广阔空间。
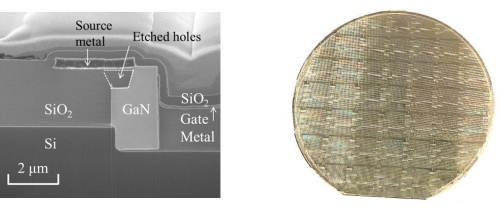
图片来源:广东致能半导体有限公司——图1(左) x-SEM 结构,图2(右)剥离硅衬底
广东致能展示全球首个垂直二维电子气氮化镓功率器件结构(如图1),此时生长用硅衬底还未被去除。图2则是垂直氮化镓器件晶圆,此时生长用硅衬底已被去除,观察面为原硅衬底面。
广东致能介绍,目前广泛应用的氮化镓功率器件多采用横向结构,但在高功率、大电流场景中仍面临电场管理、器件微缩和散热困难等技术瓶颈,难以充分发挥氮化镓材料的性能优势。相比之下,垂直氮化镓器件架构可以突破横向结构在导电能力(功率密度)及散热性能上的限制,展现出数量级的优异性能和系统集成潜力,被认为是推动氮化镓功率器件迈向更大功率的关键技术路径之一。
广东致能指出,围绕上述垂直氮化镓器件架构和工艺,公司已在国内外布局多项核心知识产权,形成完整专利组合,构筑了坚实的技术壁垒。凭借在材料外延、结构设计、工艺集成上的持续创新,垂直氮化镓功率器件平台有望成为下一代高性能氮化镓功率器件的关键技术路径。
(集邦化合物半导体整理)
更多SiC和GaN的市场资讯,请关注微信公众账号:集邦化合物半导体。
